웨이퍼(mm) 위에 그리는 밑그림(nm). Part 2 – 삼성전자 파운드리 사업부의 EUV Minimum Pitch Single Patterning
삼성전자 파운드리 사업부는 EUV Minimum Pitch Single Patterning을 주제로 논문을 IITC(International Interconnect Technology Conference)에서 발표하였습니다. 논문과 EUV기술에 관하여 보다 많은 분들에게 전달하고자 포스트를 준비하였습니다.
.
1. 얇은 선을 위해서는 더 얇은 붓으로 그리면 돼!
앞선 포스트에서 우리는 포토 공정(노광공정, Photo Lithography)이 마주한 장애물에 대하여 알아 보았는데요. 빛의 성질에 의한 한계를 근본적으로 해결하는 방안은 결국 파장을 줄이는 것이라는 이야기로 마무리 하였었습니다. 이는 파장의 길이에 따라 회절 현상의 정도가 달라지기 때문인데요. 결국 파장이 짧으면 회절로 퍼져나가는 각도를 줄일 수 있어 포토 공정의 한계를 극복할 수 있다는 것입니다. 그림[1]과 같이 얇은 선을 그리기 위해서는 얇은 붓을 사용하면 되는 것처럼 패터닝의 한계는 짧은 파장을 사용하면 해결할 수 있는 것이죠.

그렇기 때문에 포토 공정은 그림[2]와 같이 더 작은 밑그림 즉, 더 작은 패턴을 그리기 위해 빛의 파장을 줄여가며 발전해 왔습니다.

하지만 더 작은 트랜지스터를 향한 수요에 부응하기 위해서는 ArF(193nm)의 파장도 충분히 짧지는 않았습니다. 그래서 EUV(Extreme Ultra Violet)가 등장하게 되었죠.
.
2. EUV(Extreme Ultra Violet)의 출사표
파장의 한계를 극복하기 위해 혜성처럼 등장한 해결사 EUV!
EUV의 가장 큰 특징은 짧은 파장입니다. 정밀한 패터닝을 위해 짧은 파장이 필요 했고 그로 인해 도입된 것이 EUV이니까요.
우리는 그림[3]에서 볼 수 있듯 13.5nm의 굉장히 짧은 파장을 가지고 있는 EUV를 사용합니다.

기존에 사용하던 ArF의 파장이 193nm임을 생각한다면 파장이 13.5nm인 EUV는 굉장한 변화라고 볼 수 있죠. 그럼 이 굉장한 변화의 주인공 EUV를 사용하는 포토 공정의 특징을 한번 자세하게 살펴 볼까요?
A. 강력한 플라즈마가 만드는 짧은 파장
위의 그림[3]을 보면 우리에게 익숙한 무지개색의 빛 영역이 있습니다. 거기에서 파장이 짧아지는 쪽으로 가면 우리의 피부를 타게 만드는 자외선, 근육을 뚫고 지나가는 X-ray, 암세포를 죽일 정도로 강력한 감마선이 등장합니다. 즉 빛의 파장이 짧아 질수록 그 빛이 지닌 에너지가 점점 더 강력해지는 것이죠. 이처럼 파장이 짧은 빛은 큰 에너지를 가지고 있기 때문에 더 짧은 파장의 빛을 만들어 낼 때에는 평소보다 많은 에너지가 필요합니다. 홈런을 위해 야구공을 더 멀리, 빠르게 보내고 싶다면 배트를 보다 더 강하게 휘둘러야 하는 것처럼 말이죠. 그러나 기존의 DUV 빛을 만들 때 사용하던 레이저는 우리가 원하는 짧은 파장을 만들기에 에너지가 충분하지 않았죠. 그래서 EUV는 그림[4]처럼 고 에너지 상태인 플라즈마(Plasma,기체가 전자와 이온으로 분리된 상태, 고체/액체/기체 그 다음의 상태로 높은 에너지를 지님)를 이용합니다.
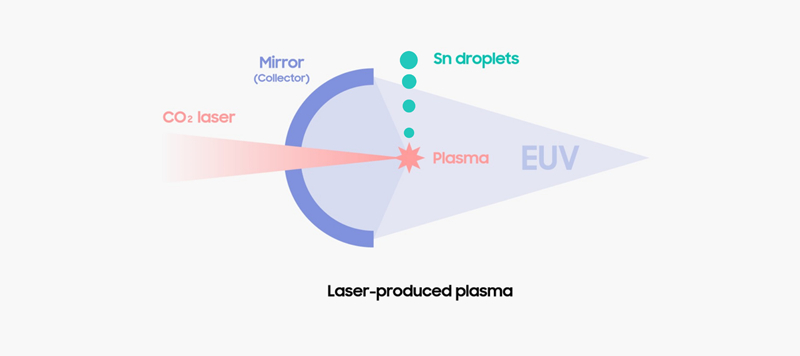
그림[4]처럼 EUV를 만들어 내는 과정에는 꼭 필요한 특별한 기구가 하나 있습니다. 바로 빛을 모아주는 거울입니다! 거울은 EUV를 만들 때 뿐만 아니라 EUV를 사용하는 공정 전반에 걸쳐 사용 되는 매우 중요한 요소 중에 하나 인데요. 이어서 EUV 기술의 핵심인 거울에 대해서 알아 보겠습니다.
B. 반사광학계 – 돋보기가 아닌 거울을 이용.
빛은 파장이 짧을 수록 다른 물질에 쉽게 흡수되어 버린다는 특징이 있습니다. EUV는 파장이 매우 짧아 대기중에서도 흡수가 되어버릴 정도이죠. 이를 방지하기 위해 EUV설비(EUV를 활용하는 포토 공정 장비)는 내부를 진공상태로 만들고 공정을 진행합니다. EUV를 이용해 공정을 진행 할 때 거울을 사용하는 이유도 이러한 빛의 흡수를 줄이기 위해서 인데요. EUV의 파장이 매우 짧아 빛이 렌즈를 통과하는 과정에서 다량의 빛이 렌즈에 흡수되어 버리기 때문입니다. 그래서 기존에 사용하던 렌즈 대신 거울을 활용해 빛이 투과가 아닌 반사 되게 하여 흡수되어 버리는 양을 줄인 것이죠. 흡수를 최소화 하여 그림[5]처럼 빛이 무사히 감광액까지 도달 해야 온전한 패터닝이 이루어 지니까요.

여기서 의문이 하나 생기게 됩니다. 빛을 통과시켜야 하는 마스크는 어떻게 하지? EUV를 활용하는 공정은 마스크 역시 반사를 활용하도록 제작하여 사용합니다. 그림[6] (a)처럼 빛을 막는 영역과 투과되는 영역으로 구성된 기존의 마스크를 (b)와 같이 반사가 되는 영역과 빛이 흡수가 되어버리는 영역으로 구성된 마스크로 바꾼 것이죠.
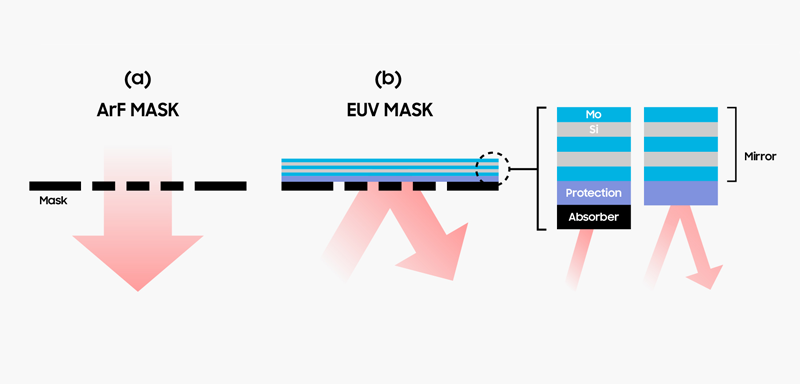
지금까지 설명한 EUV 포토 공정을 한눈에 볼 수 있게 간략하게 표현한다면 그림[7]과 같습니다.

그리고 EUV를 ArF와 간략하게 비교해 다시 정리해 보자면, 그림[8]과 같습니다.

그림[8]처럼 기존과 완전히 다른 방식의 EUV 포토 공정은 우리가 그려낼 수 없었던 더 작은 것을 그릴 수 있게 하였죠. 하지만 EUV는 단순하게 지금 구현 가능한 크기의 패턴보다 작은 패턴을 그릴 수 있다는 장점에서 끝나지 않습니다.
.
3. 그릴 수 없는 것을 그리고, 여러 번에 걸쳐 그리던 것은 한번에 그리고!
앞선 PART1 포스트에서 우리는 파장의 한계를 극복하기 위해 하나의 그림을 여러 번에 나눠 그리는 방식을 활용하였다고 소개하였었습니다. 바로 MPT(Multiple Patterning Technology)인데요. 이 MPT는 작은 패턴을 그릴 수 있다는 장점이 있지만, 그림[9] (a)처럼 마스크도 여러 개 필요하고 공정도 여러 번에 거쳐 진행해야 한다는 단점이 있습니다. 하지만 파장이 짧은 EUV는 (b)처럼 단 하나의 마스크와 단 한번의 포토 공정으로 이 패턴을 그릴 수 있게 하죠.
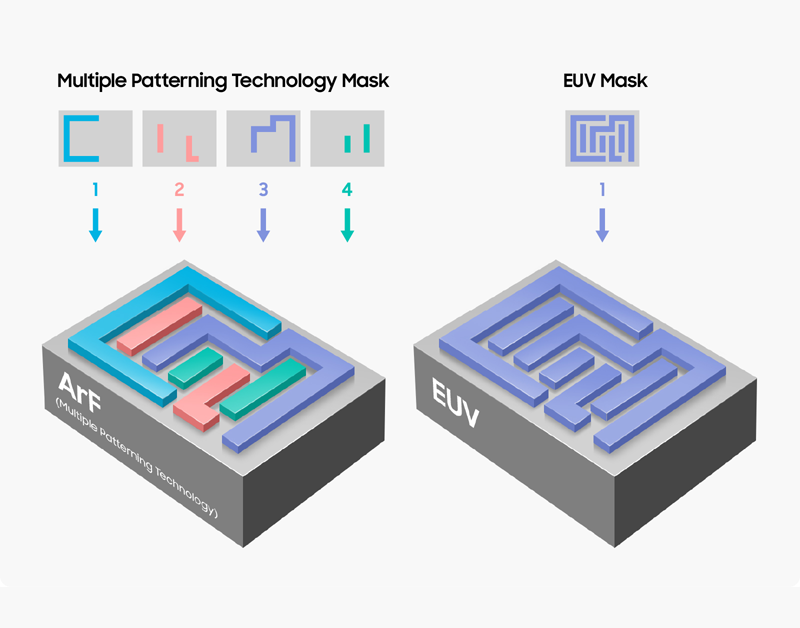
이러한 변화는 시간과 수율 그리고 비용적 이점을 가져다 주었습니다.
A. 시간 – 공정 진행 소요시간 단축
결과물을 얻는데 필요한 단계가 많아지면 그만큼 시간이 오래 걸리게 됩니다. 아주 간단한 비유를 들어 설명한다면 그림[9]의 (a)가 4시간에 빵을 하나 만드는 공장이라면 (b)는 1시간에 빵을 하나 만드는 공장인 셈이죠. 단계를 줄여 이전 보다 훨씬 빠른 진행이 가능하게 된 것입니다.
B. 수율 – 오염을 줄여 수율 향상
여러 번에 거쳐 진행된다는 것은 오염될 가능성이 여러 번 존재 한다는 말과 같습니다. 여러 번 주무를수록 더러워지는 하얀 점토처럼요. 반도체 공정에서 오염은 수율 하락의 원인으로 작용하기 때문에 EUV는 이러한 수율 하락의 원인을 줄여준 셈이죠.
C. 비용 – MASK 제작 비용 감소
Mask제작에도 비용이 필요합니다. 여러 장 만들던 Mask를 EUV를 활용하며 한 장으로 줄일 수 있었으니, 이에 따라 제작 비용도 감소하게 되었습니다.
.
4. 좋은 칼은 실력 좋은 요리사와 함께해야 한다.
이처럼 EUV는 등장과 함께 큰 이점을 가져다 주었고, 이제는 이 훌륭한 도구를 어떻게 더 효과적으로 활용할 수 있을지에 대하여 탐구와 노력이 동반 되어야 할 시기입니다.
다음 포스트에서는 EUV의 능력치를 더욱 끌어 올리기 위한 삼성전자 파운드리 사업부의 활동들에 대하여 알아 보도록 하겠습니다.
.
.
