반도체 8대 공정 9탄. 외부환경으로부터 반도체를 보호하는 패키징(Packaging) 공정
지난주, 제품으로 가는 첫 번째 관문인 EDS(Electrical Die Sorting) Test에 대해 알아보았는데요. 이번에는 반도체 8대 공정 시리즈 마지막 탄으로, Packaging 공정과 Package Test에 대해 알아보겠습니다.
■ 외부환경으로부터 보호하고 단자 간 연결을 위한 전기적인 포장, 패키징(Packaging)
일반적으로 패키징(Packaging)이란 ‘상자에 채워 형태를 정리한다’는 사전적 의미를 갖고 있습니다. 하지만 반도체에서 패키징은 ‘반도체 칩을 탑재될 기기에 적합한 형태로 만든다’는 의미로 사용됩니다.
이 반도체 칩, 즉 집적회로(IC)는 기판이나 전자기기의 구성품으로서 필요한 위치에 장착되기 때문에, 그에 맞는 모양으로 전기적인 포장(Packaging)을 해야 합니다.
예를 들어, IT제품을 사람의 신체에 비유하면, 집적회로(IC)는 두뇌에 해당하고, 패키징은 ‘신경계통’과 ‘골격구조’에 해당 한다고 볼 수 있습니다.
즉 패키징은 상호배선, 전력공급, 방열, 그리고 집적회로(IC) 보호와 같은 역할을 합니다. 특히, 집적회로는 고온, 고습, 화학약품, 진동/충격 등 다양한 외부환경으로부터 안전하게 보호될 수 있도록 패키징 되어야 합니다.
자 그러면, 패키징 공정이 어떻게 이루어지는지 함께 알아 볼까요?
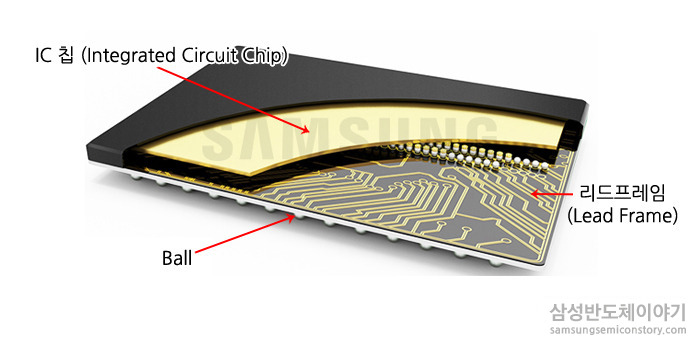
먼저, EDS Test의 Inking 공정(불량제품 식별을 위해 칩에 특수잉크를 찍는 공정)을 거친 웨이퍼를 다이아몬드 절단기로 잘라 낱개의 칩으로 분리합니다. 절단된 칩들은 리드 프레임(Lead Frame) 또는 PCB (Printed Circuit) 위에 올려 전기적 연결 구실을 할 BALL을 달게 되는데요,
여기서, 리드 프레임은 반도체 칩과 실리콘 기판 사이 전기신호를 전달하고, 외부의 습기나 충격 등으로부터 칩을 보호 및 지지해 주는 골격 역할을 합니다.
그렇다면, 반도체 칩과 리드 프레임은 어떻게 연결될까요?
혹시 뉴스에 반도체 소식이 보도될 때, 기판 위 올려진 칩들 사이사이로 설비가 빠르게 움직이며 선을 연결하는 장면을 기억하시나요? 이 장면이 바로, 금속 연결(Wire Bonding) 공정인데요, 금속 연결(Wire Bonding) 공정은 반도체 칩의 접착점과 리드프레임 간 전기적 특성을 위하여 가는 금선을 사용하여 연결하는 공정입니다.
금속 연결 공정까지 끝나면 열 및 습기 등의 물리적인 환경으로부터 반도체 집적회로를 보호하고, 원하는 형태의 패키지로 만들기 위해 성형(Molding) 공정 을 거칩니다. 성형은 수지(Resin)로 구성된 EMC(Epoxy Molding Compound)에 고온을 가해 젤 상태로 만든 후, 원하는 형태의 틀에 넣어 진행합니다.
이제 여러분이 일상에서 만나는 반도체의 모습이 완성되었습니다.
■ 견뎌야 비로소 생활 속 제품이 되리라! 최종 관문이라 불리는 패키지 테스트(Package Test)
패키징 공정이 완료되면, 이 패키지가 올바른 기능을 하는지 확인해야합니다. 즉, 패키지 테스트(Package Test)는 패키지 형태로 만들어진 제품의 최종 불량유무를 선별하는 검사(Test)입니다.
이 테스트는 완제품 형태를 갖춘 후, 검사가 진행되기 때문에 Final Test라고도 하는데요, 패키지 테스트는 반도체를 검사장비(Tester)에 넣고 다양한 조건의 전압이나 전기신호, 온도 등을 가해 제품의 전기적 특성, 기능적 특성, 동작 속도 등을 측정하여 불량유무를 구별합니다.
또한, 테스트 중 발생하는 데이터를 수집·분석해 그 결과를 제조공정이나 조립공정에 피드백해 제품의 질을 개선하는 역할을 하기도 합니다.
반도체는 각 제품별로 그에 적합한 패키지 테스트를 거치는데요, 메모리 제품인 DRAM을 기준으로 패키지 테스트 과정을 살펴보겠습니다.
| 1) Assembly Out 제품의 첫 테스트는 Assembly Out으로 제품 종류, 수량, I/O 수(Bit 수) 등을 확인해 제품 검사지(Lot Card)를 작성하는 공정입니다. 제품 검사지에는 모든 공정 과정과 시간, 수율, 담당자, 사용 프로그램 등이 기록되는데요, 이 검사지는 입고 시부터 제품과 함께 이동하고, 출고 후에도 일정 기간 보관됩니다. 2) DC test & Loading / Burn-in (& Unloading) DC test는 FAB 및 조립공정을 거치면서 발생된 불량을 선별하는 공정인데요, 이 단계를 거치면 초기불량을 선별을 위한 Burn-in 공정이 진행됩니다. Burn-in이란 불량 가능성이 있는 제품을 사전에 제거하기 위한 공정인데요, 제품에 고전압, 고온, 전기신호 등 극한 조건을 가하게 되며 이후 별도의 테스트를 통해 양품과 불량품을 선별하게 됩니다. 이러한 검증을 과정을 통과해야만 PC나 IT제품 등의 전자기기가 오류없이 동작할 수 있는 신뢰성을 확보하게 됩니다. 3) MBT (Monitoring Burn-in & Tester) MBT 공정은 제품에 열적, 전기적인 극한 조건을 가하는 과정에 테스터 기능까지 추가된 공정인데요, Burn-in 공정에 비해 불량분석 기간을 단축할 수 있고, 품질 불량을 보다 강화할 수 있는 장점이 있습니다. 4) Post Burn Test 위 테스트 과정을 통과한 제품들은 상온 및 저온 공간에서 전기적 특성 및 기능을 검사 받게 되는데요, 이 공정을 통과한 제품만이 Final Test로 가는 티켓을 받게 됩니다. 5) Final Test 상온 및 저온에서 진행되는 Post Burn Test를 무사히 통과한 반도체 제품들을 기다리고 있는 것은 바로 고온의 검사인데요, Final Test는 고온에서 반도체의 전기적 특성 및 기능을 검사하는 공정입니다. |
이렇게 패키지 테스트(Package Test)까지 완료된 반도체는 비로소 고유의 이름을 갖게 됩니다. 제품 표면에 인쇄되는 고유이름에는 IC의 명칭, 제조일, 제품의 특성, 제조 국가, 일련번호 등 제품에 대한 이력이 담겨 있습니다.
이제 완료된 제품은 비즈니스 및 고객사의 요구조건에 따라 출하 방식이 결정되는데요, 이 때, 제품의 품질(Quality)을 보증하기 위해 최종적으로 출하 검사가 실시되어 합격을 받은 제품만이 출하되는 것이죠!
자 어떠신가요? 주변을 둘러보세요. 정말 우리 생활에서 반도체는 IT 제품뿐 아니라 다양한 곳에서 손쉽게 찾아볼 수 있습니다. 실리콘으로 된 규소봉에서 추출한 원판형 웨이퍼가 손톱보다 작은 크기의 반도체가 되어 우리 곁에 오기까지, 복잡하고 세밀한 많은 공정을 거치는 것을 알 수 있었습니다.
많은 사람의 삶에서 중요한 역할을 하는 반도체, 앞으로 우리의 삶을 더 행복하고 풍요롭게 해줄 반도체의 무궁 무진한 앞날을 기대해봅니다.

☞ 반도체 8대 공정 1탄. 반도체 집적회로의 핵심재료, 웨이퍼란 무엇일까요?
☞ 반도체 8대 공정 2탄. 웨이퍼 표면을 보호하는 산화공정(Oxidation)
☞ 반도체 8대 공정 3탄. 전자산업의 혁명, 집적회로(IC, Integrated Circuit)
☞ 반도체 8대 공정 4탄. 웨이퍼에 한 폭의 세밀화를 그려 넣는 포토공정(Photo)
☞ 반도체 8대 공정 5탄. 특정 회로패턴을 구현하는 식각공정(Etching)
☞ 반도체 8대 공정 6탄. 반도체가 원하는 전기적 특성을 갖게 하려면?
☞ 반도체 8대 공정 7탄. 전기를 통하게 하는 마지막 작업, 금속 배선 공정
☞ 반도체 8대 공정 8탄. 합격으로 가는 첫 번째 관문 EDS(Electrical Die Sorting)